2026年,3D新架构将让国产AI芯片“弯道超车”
(来源:六安新闻网)
转自:六安新闻网
随着芯片产业走向“后摩尔定律”时代,3D集成技术正悄然成为突破计算芯片制造架构瓶颈的关键选项。
近期,美国斯坦福大学、卡内基梅隆大学、宾夕法尼亚大学和麻省理工学院等机构的工程师合作开发首款由美国商业晶圆代工厂量产制造的新型3D计算芯片架构芯片,性能比同类2D芯片提升约四倍、AI工作负载性能提升12倍。对此,美国斯坦福大学教授米特拉(Subhasish Mitra)表示,正是3D技术突破,才能实现未来 AI 系统所需的1000倍芯片硬件性能提升。
相较于美国市场,国内面临先进工艺产能及高端 HBM(高带宽内存)供给受限的客观产业条件,以“空间堆叠”为核心的3D可重构架构,正成为国产 AI 芯片突破性能天花板的关键技术演进方向。
在12月20日举行的“第四届HiPi Chiplet论坛” 3D IC分论坛上,清微智能联合创始人兼首席技术官欧阳鹏表示,国产高端AI芯片有望在2026年通过3D可重构架构技术,实现对国际主流高端AI芯片的超越。

随着在AI大模型快速迭代、算力需求指数级攀升的背景下,芯片任务的复杂度不断提升,2.5D单芯片的优化已显得杯水车薪,那么,AI芯片封装和架构层面的两大核心瓶颈也随之凸显:
一是“内存墙”问题。数据显示,基于Transformer架构的AI模型参数规模大约每2年就会增加240倍,计算过程中需存取大量中间数据和权重,但是单个GPU的内存容量每2年仅能实现2倍的增长,AI存储和带宽增长跟不上模型迭代的速度和要求。
二是芯片面积瓶颈问题。2.5D技术是单一平面扩展,布局布线资源受限,集成密度低,在AI高算力的场景下,芯片面积无法进一步压缩,亟待用三维集成等技术解决“小型化”瓶颈。
针对诸多行业挑战,2024年计算机体系结构领域顶会ISCA上,清华大学集成电路学院尹首一教授带领团队,发表了题为《Exploiting Similarity Opportunities of Emerging Vision AI Models on Hybrid Bonding Architecture》的论文,首次通过混合键合技术实现逻辑芯片与DRAM的3D可重构,构建了具有超高带宽的三维DRAM存算一体架构,从而提升AI芯片算力能效和面积效率。
论文显示,与最先进的2D/2.5D AI加速器相比,新架构的平均能效提升2.89倍至14.28倍,面积效率提升2.67倍至7.68倍。引入聚类相似效应(Clustering Similarity Effect)优化后,能效和面积效率的提升分别为5.69倍-28.13倍,以及3.82倍-10.98倍。
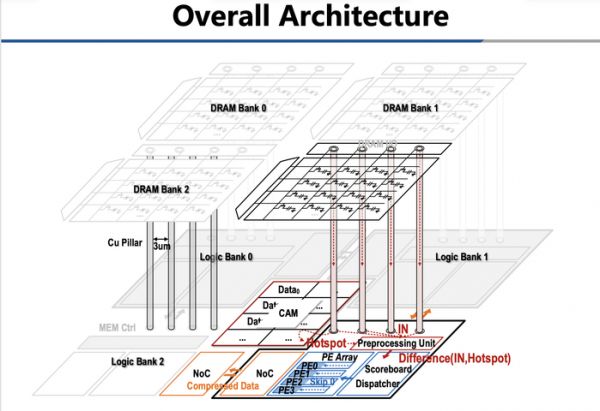
在“第四届HiPi Chiplet论坛” 3D IC分论坛上,清微智能技术总监梁华岳博士以“三维可重构计算架构设计实践”为题发表演讲。梁华岳表示,可重构分布式数据流计算模式与三维集成存储架构天然适配,可充分发挥三维集成架构的效能。与二维集成技术相比,三维可重构计算架构的有效带宽提升10倍。
中茵微电子(北京)有限公司创始人兼董事长王洪鹏表示,从行业趋势来看,随着模型规模持续提升、存储带宽需求不断增加,以及云、边、端应用场景日趋复杂,3D ASIC将成为AI领域极具价值的技术分支。他认为,当前3D可重构架构的IP解决方案正逐步丰富,能够进一步帮助客户节约成本、缩短设计周期,并降低芯片设计风险。
上海方宜万强微电子有限公司CEO陈卫荣指出,未来AI大模型算力的增长一定不是单芯片,而是要多芯片、多Chiplet、多卡、多节点方向。3D Chiplet优势非常明显,不仅可以降低IP移植成本、降低设计成本、降低开发门槛,还能让大家专注于功能开发,并用Die、Chiplet等技术解耦,让大家做并行开发、解耦开发,减少开发迭代周期,降低开发成本。
展望未来,清华大学集成电路学院尹首一团队胡杨老师以“晶圆级芯片计算架构与集成架构研究”为题发表主题演讲。胡杨表示,AI大模型催生了存储容量、存储带宽以及多芯片集群协同等方面的庞大算力需求,给整个芯片系统的设计带来了一定挑战。不仅如此,MoE(混合专家)模型还使得多卡之间的互联与通信能力成为性能提升的关键瓶颈。基于此,胡杨提出构建晶圆级AI芯片和晶圆级计算机,从而有效提升算力密度、互联效率与通信带宽。
江西沃格光电集团股份有限公司副总裁兼首席战略官王鸣昕指出,玻璃基线路板在散热、集成度、可靠性方面优于传统基板,随着先进封装从2.5D走向3D,基于玻璃基先进封装以及异构的多片堆叠技术能助力大规模的Chiplet芯片集成,同时使用玻璃板的面板嵌入技术能够优化散热性能,减少热隔离插入损耗和集成损耗。
中国科学院微电子研究所研究员金仁喜以“混合键合一些表面检测需求探讨”为题发表主题演讲。他表示,混合键合基于传统技术,通过柔性材料的互联方式形成高互联密度结构,而这种特殊结构对晶圆表面提出了极高要求。未来,随着表面颗粒观测溯源与抑制研究逐步从实验室走向产业化,异质集成、3D IC 等技术将成为芯片架构层面最理想的发展方向。

不仅是学术层面,如今,3D可重构架构技术已经商业落地,并有望成为中国AI芯片“弯道超车”的主战场。
弗若斯特沙利文预测,到2029年,中国的AI芯片市场规模将从2024年的1425.37亿元激增至13367.92亿元,期间年均复合增长率为53.7%。
国内市场方面,国产AI芯片有望在2026年采用3D可重构新架构。作为源自清华大学的全球可重构架构计算领导者,清微智能在3D可重构AI架构技术方面布局较早,有充足专利储备,并且正加速整合国内相关产业链。
早在2019年,清微智能和清华大学团队就开展了3D可重构AI架构相关研究,自2023年1月开始,清微智能在中美进行3D芯片相关的大量专利布局。另外在产业层面,清微智能正在与清华大学、智源研究院、智谱等上下游产业链机构共同构建国产AI生态。
凭借自研可重构计算芯片技术,截至今年12月,清微智能的可重构芯片累计出货量已超3000万颗,2025年其算力卡订单累计超3万张,在全国十余座千卡规模智算中心实现规模化落地。截至2025年上半年,清微智能AI加速卡出货量位居国产商用类企业第一梯队。
此外,清微智能的新一代基于3D可重构架构技术的云端算力产品,计划2026年推出,将全面对标国际主流的高端AI芯片。(千龙网)
免责声明:本内容为广告,相关素材由广告主提供,广告主对本广告内容的真实性负责。本网发布目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,广告内容仅供读者参考,如有疑问请联系:0564-3996046。
相关推荐
2026年,3D新架构将让国产AI芯片“弯道超车”
中国汽车芯片开始“弯道超车”?
智能汽车“增量部件”争夺战:汽车芯片没有弯道超车
9个月投入1105亿,国产量子芯片弯道超车,盖茨:“无法阻挡”
154 万 AI 开发者用数据告诉你,中国 AI 如何才能弯道超车?
新火种AI|字节“扣子”正式加AI战场!2024年能否实现弯道超车?
焦点分析 | 新冠疫苗让Moderna一夜暴涨20%,国产疫苗也迎来了百年一遇的弯道超车机会
重磅!中国团队发布SRDA新计算架构,从根源解决AI算力成本问题,DeepSeek“神预言”成真?
几乎“全军覆没”?马斯克宣布新突破,外媒:6G弯道超车失败了
智能汽车时代,国产汽车弯道超车
网址: 2026年,3D新架构将让国产AI芯片“弯道超车” http://www.xishuta.com/newsview145616.html
推荐科技快讯

- 1问界商标转让释放信号:赛力斯 95792
- 2报告:抖音海外版下载量突破1 25736
- 3人类唯一的出路:变成人工智能 25175
- 4人类唯一的出路: 变成人工智 24611
- 5移动办公如何高效?谷歌研究了 24309
- 6华为 nova14深度评测: 13155
- 7滴滴出行被投诉价格操纵,网约 11888
- 82023年起,银行存取款迎来 10774
- 9五一来了,大数据杀熟又想来, 9794
- 10手机中存在一个监听开关,你关 9519










